
Mini SOD-123FL package
Release Date:2020-07-18
Abstract: The SOD-123FL package can directly replace the SOD-123 seagull pin product. It adopts a new packaging technology with a small footprint and a frame welding process that provides high reliability and large current capacity. The watt/MM2 thermal performance of the package is 149% higher than SOD123, 90.5% higher than SMA, and 26.5% higher than Powermite.
The pin structure and wire clamp design of the SOD-123FL package allows low forward voltage. The internal design with a wire clip has better surge current capability than a wire-bonded package, and is suitable for transient voltage suppression applications. Use low leakage current silicon technology in the new package to save energy.
The SOD-123FL package uses 100% tin (Sn) to coat all the surface plating surfaces. It is reflowed at 260°C to reach the first level of moisture sensitivity level (MSL), and is backward compatible with the existing reflow process.
The thickness (maximum 1.2mm) is 25% or more lower than the standard SOD123 package, which is suitable for portable applications with limited circuit board space.
Features:
1: New packaging technology with high power, small package and full frame type.
2: The footprint is 46% less than SMA, 65% less than SMB, 85% less than SMC Height 45% lower than SMA, 50% lower than SMB, 50% lower than SMC:
3: It can be used directly instead of SOD-123 seagull foot products, with large current capacity, GPP glass passivation covers 0.5-1A, Schottky Schottky covers 1-3A.
4: The frame welding process is adopted, which provides high reliability and large current capacity.
5: Low thermal resistance, low junction temperature and high anti-surge design, the lead is flat on the bottom of the device, the heat dissipation path is short, the shape of the chip lead frame for silicon chip heat dissipation is improved, the ability to resist forward surge is strong, and the small size is realized High-power technological breakthrough.
Package SOD-123FL size (see the figure below for details)
Size
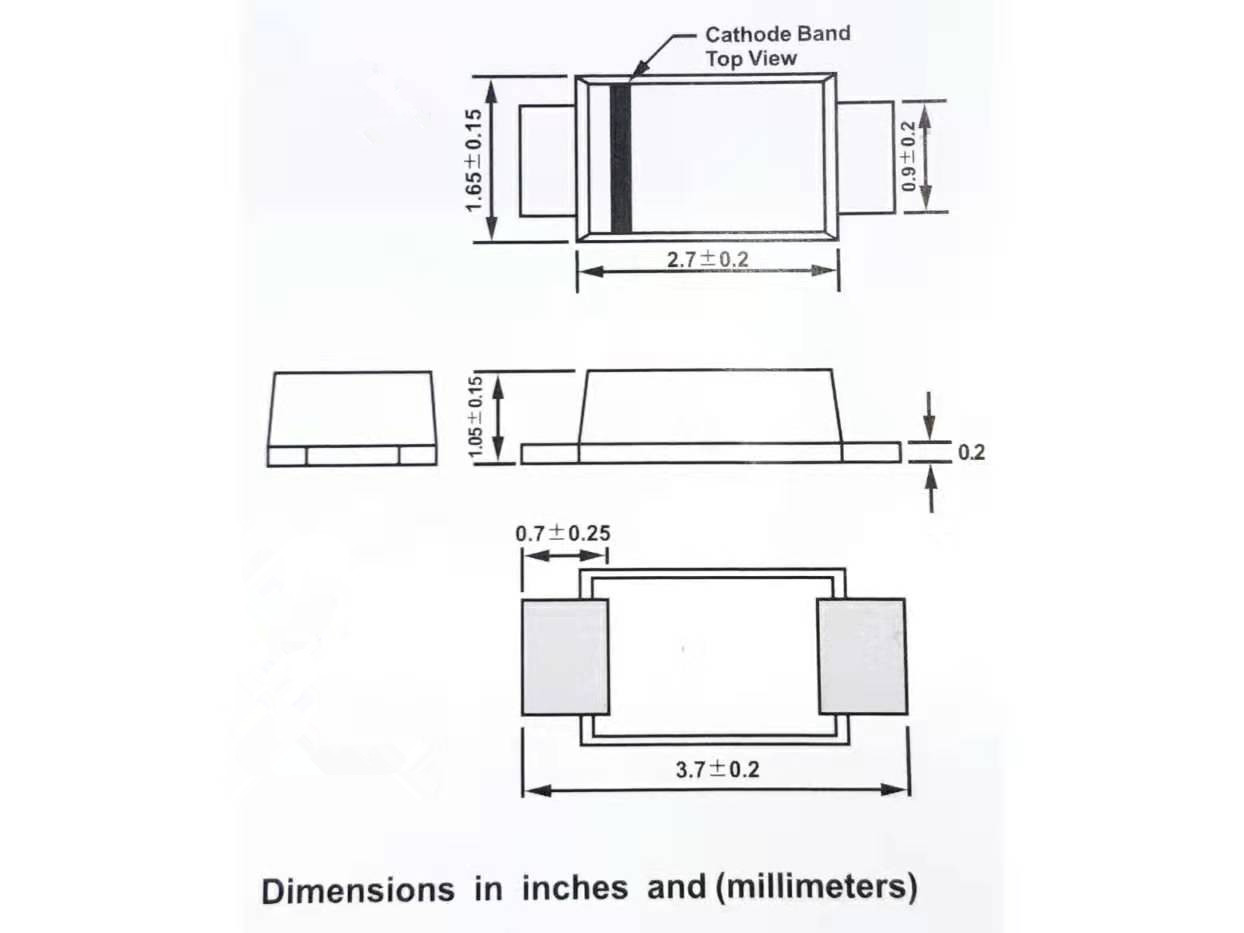
The pin structure and wire clamp design of the SOD-123FL package allows low forward voltage. The internal design with a wire clip has better surge current capability than a wire-bonded package, and is suitable for transient voltage suppression applications. Use low leakage current silicon technology in the new package to save energy.
The SOD-123FL package uses 100% tin (Sn) to coat all the surface plating surfaces. It is reflowed at 260°C to reach the first level of moisture sensitivity level (MSL), and is backward compatible with the existing reflow process.
The thickness (maximum 1.2mm) is 25% or more lower than the standard SOD123 package, which is suitable for portable applications with limited circuit board space.
Features:
1: New packaging technology with high power, small package and full frame type.
2: The footprint is 46% less than SMA, 65% less than SMB, 85% less than SMC Height 45% lower than SMA, 50% lower than SMB, 50% lower than SMC:
3: It can be used directly instead of SOD-123 seagull foot products, with large current capacity, GPP glass passivation covers 0.5-1A, Schottky Schottky covers 1-3A.
4: The frame welding process is adopted, which provides high reliability and large current capacity.
5: Low thermal resistance, low junction temperature and high anti-surge design, the lead is flat on the bottom of the device, the heat dissipation path is short, the shape of the chip lead frame for silicon chip heat dissipation is improved, the ability to resist forward surge is strong, and the small size is realized High-power technological breakthrough.
Package SOD-123FL size (see the figure below for details)
Size
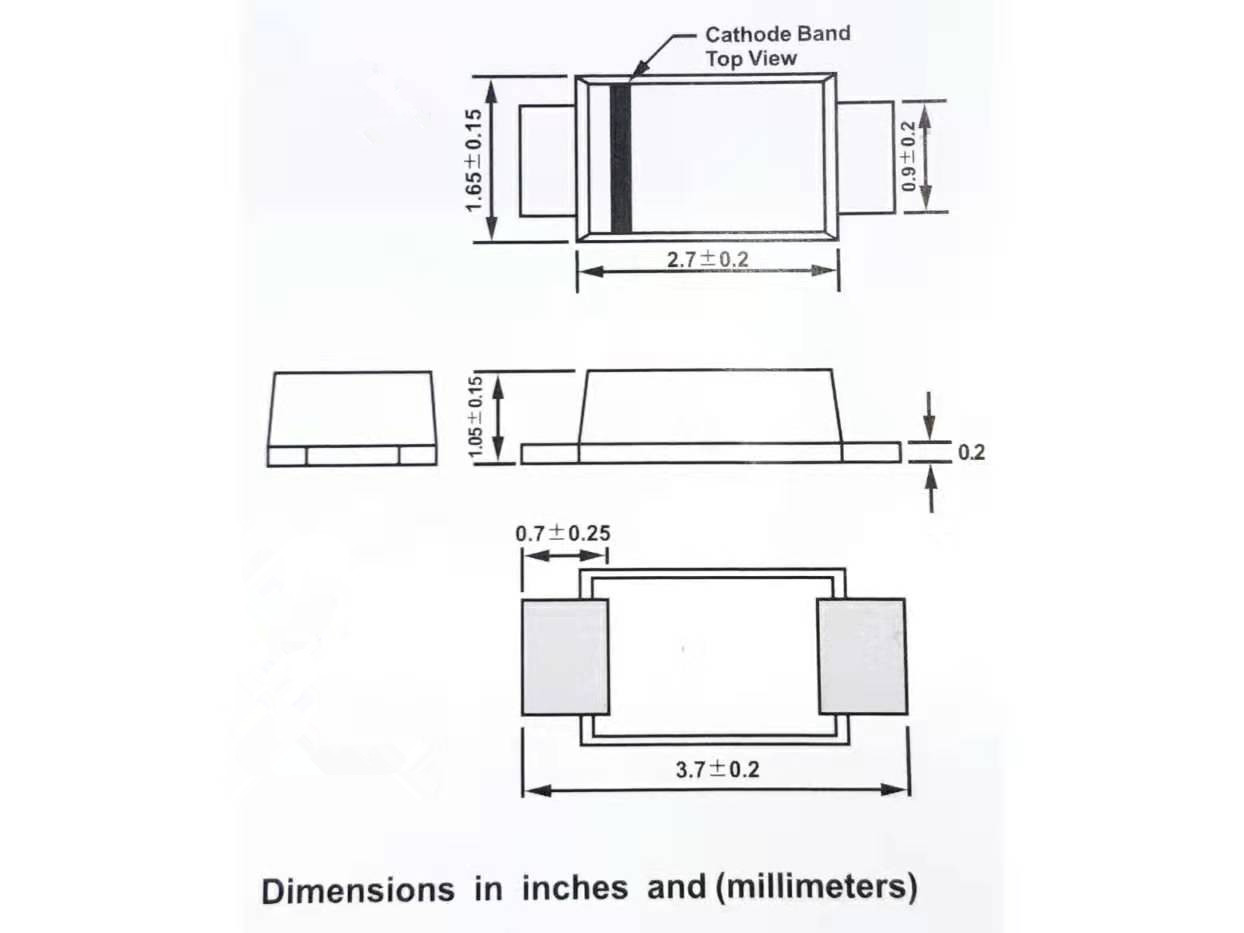
.jpg)





.jpg)
